Organized by EPS’s TC on Electrical Design, Modeling & Simulation
Speaker: Dr. Feng Ling, Xpeedic
On-demand video:  (26:50 plus Q&A)
(26:50 plus Q&A)
Meeting Date: Friday, May 24, 2024
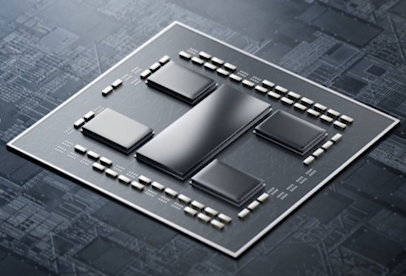 Summary: The emergence of multi-die 2.5D/3D IC designs requires fundamental changes for conventional EDA tools and methodologies in terms of system-level architectural exploration, physical implementation, analysis and sign-off, verification, and design for manufacturing. This talk will focus on the challenges and solution for signal integrity analysis of 2.5D/3D multi-die packages. A novel electromagnetic solver delivering unprecedented performance advantages with uncompromised accuracy will be introduced. Benchmark examples on various advanced packaging platforms demonstrate its accuracy and efficiency.
Summary: The emergence of multi-die 2.5D/3D IC designs requires fundamental changes for conventional EDA tools and methodologies in terms of system-level architectural exploration, physical implementation, analysis and sign-off, verification, and design for manufacturing. This talk will focus on the challenges and solution for signal integrity analysis of 2.5D/3D multi-die packages. A novel electromagnetic solver delivering unprecedented performance advantages with uncompromised accuracy will be introduced. Benchmark examples on various advanced packaging platforms demonstrate its accuracy and efficiency.
 Bio: Dr. Feng Ling is the founder and CEO of Xpeedic, a leading simulation EDA provider for IC, package, and system designs. Dr. Ling has over 20 years’ industry experience spanning from Motorola SPS (now NXP) to EDA startups Neolinear (acquired by Cadence), Physware (acquired by Siemens EDA) and Xpeedic. Dr. Ling received his Ph.D. degree in electrical engineering from the University of Illinois at Urbana-Champaign (UIUC) in 2000. He is a Senior Member of IEEE. He has authored and co-authored 3 book chapters and more than 60 papers in refereed journals and conference proceedings.
Bio: Dr. Feng Ling is the founder and CEO of Xpeedic, a leading simulation EDA provider for IC, package, and system designs. Dr. Ling has over 20 years’ industry experience spanning from Motorola SPS (now NXP) to EDA startups Neolinear (acquired by Cadence), Physware (acquired by Siemens EDA) and Xpeedic. Dr. Ling received his Ph.D. degree in electrical engineering from the University of Illinois at Urbana-Champaign (UIUC) in 2000. He is a Senior Member of IEEE. He has authored and co-authored 3 book chapters and more than 60 papers in refereed journals and conference proceedings.
